Є ціла низка експериментальних даних незворотної взаємодії лазерного випромінювання з вузькозонними напівпровідниками АIIIВV [1-3]. Ці результати наводять на думку, що в напівпровідниках при опроміненні випромінюванням рубінового лазера виникають дефекти локального типу з різними енергіями активації та відпалу. Ці дефекти мають n-тип провідності. Енергетична залежність для розподілу n-центрів у приповерхневому шарі подана на рис.1 кривою 1 [1]. Ці n-центри зумовлені дефектами (крива 2, рис. 1). Окрім того вони мають низьку рухливість, майже на порядок меншу від вільних носіїв. При термообробці кількість носіїв у шарі зменшується. Однак частина n-центрів для досить високих інтенсивностей опромінення зберігає свою стійкість при T=4000C в InSb та при T=8000C в InAs. Слід зазначити, що концентрація оптично генерованих дефектів настільки велика, що при середніх дозах іонної імплантації додаткове опромінення імпульсами рубінового лазера призводить до збільшення кількості дефектів (крива 3, рис. 1), тоді як опромінення імпульсами лазера на СО2 призводить до відпалу дефектів (крива 4 рис. 1) та до активації впровадженої домішки [1]. При цьому концентраційний профіль залежить від кристалографічної орієнтації [2; 3] (рис. 2). Це зумовлено тим, що кристали InSb мають значний процент ковалентних зв’язків, що й призводить до анізотропії дефектоутворення. У спектрах оберненорозсіяних іонів у режимі каналювання зареєстрована генерація дефектів решітки в приповерхневому шарі [1-3] кристалів InSb під дією випромінювання рубінового лазера з густиною енергії в імпульсі I0=0,018¸ ¸0,078 Дж×см-2 до рівня, який реєструється методикою. Відносна зміна дефектності cD зображена кривою 2 на рис.1. Співставляючи дані для cD=f(I0) та для nS=f2(I0) (де nS – шарова концентрація), легко бачити, що генерація n-центрів зумовлена дефектоутворенням під дією  лазерного випромінювання, що лежить в області власного поглинання. Зменшення дефектності спостерігається при опроміненні з  Більш повно відносну зміну дефектності від густини енергії в імпульсі характеризує крива 2 на рис.1, яка показує, що при  близькому до близькому до  в шарі досягається мінімальний рівень дефектності, що реєструється методикою. в шарі досягається мінімальний рівень дефектності, що реєструється методикою. На рис. 3 наведено динаміку поведінки дефектів після опромінення імпульсами рубінового лазера різної інтенсивності.  Ці ефекти пояснюються тим, що при взаємодії лазерного випромінювання з hn³Eg відбувається інтенсивне дефектоутворення. Причому концентрація дефектів та час їх життя суттєво залежать від інтенсивності їхнього введення, тобто від інтенсивності опромінення. В класичній фізиці напівпровідників вважається, що при взаємодії оптичного випромінювання, частота якого лежить у смузі власного поглинання монокристала, з напівпровідником відбувається адіабатичний процес повернення кристала в початковий стан. Однак, як видно з вищенаведеного, це не так. Наведемо спрощену модель процесу взаємодії лазерного випромінювання з антимонідом індію. Цей кристал може перебувати в наступних фазах (кристалографічних модифікаціях): сфалериту (кубічна), вюрциту (гексагональна), полікристалічній та аморфній. Кожній з цих модифікацій відповідає своя структура та симетрія енергетичних зон кристала. Перехід між ними супроводжується зміною внутрішньої (потенціальної) енергії кристала. Слід зазначити, що фізика взаємодії оптичного випромінювання у смузі власного поглинання з точки зору релаксаційної оптики як слід не розроблена. Ці ефекти пояснюються тим, що при взаємодії лазерного випромінювання з hn³Eg відбувається інтенсивне дефектоутворення. Причому концентрація дефектів та час їх життя суттєво залежать від інтенсивності їхнього введення, тобто від інтенсивності опромінення. В класичній фізиці напівпровідників вважається, що при взаємодії оптичного випромінювання, частота якого лежить у смузі власного поглинання монокристала, з напівпровідником відбувається адіабатичний процес повернення кристала в початковий стан. Однак, як видно з вищенаведеного, це не так. Наведемо спрощену модель процесу взаємодії лазерного випромінювання з антимонідом індію. Цей кристал може перебувати в наступних фазах (кристалографічних модифікаціях): сфалериту (кубічна), вюрциту (гексагональна), полікристалічній та аморфній. Кожній з цих модифікацій відповідає своя структура та симетрія енергетичних зон кристала. Перехід між ними супроводжується зміною внутрішньої (потенціальної) енергії кристала. Слід зазначити, що фізика взаємодії оптичного випромінювання у смузі власного поглинання з точки зору релаксаційної оптики як слід не розроблена. При спрощеному розрахунку взаємодія кванта оптичного випромінювання з енергією 1,78 еВ з антимонідом індію, ширина забороненої зони якого при кімнатній температурі дорівнює 0,18 еВ, відповідає енергії мінімального хімічного зв’язку в кристалі (оскільки кристали антимоніду індію прямозонні). Окрім того, цей напівпровідник більш як на половину ковалентний. З кристалографічної точки зору чистий ковалентний зв’язок 1 відповідає ширині забороненої зони кристала (рис. 4). 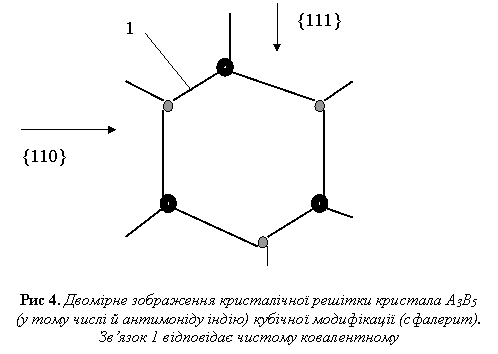 З чисто геометричних міркувань видно, що в кристалографічному напрямку {111} переріз ефективної взаємодії кванта рубінового лазера зі зв’язком 1 більш ефективний, ніж для напрямку {110}. Кванти рубінового лазера при доволі низьких інтенсивностях опромінення (однофотонні процеси) з іншими зв’язками практично не взаємодіють, тому що їхня енергія значно менша за енергію цих зв’язків. Простий геометричний підрахунок стверджує, що у випадку сферичного чи еліпсоїдального зв’язку співвідношення площ зв’язку 1 з рис.4 буде дорівнювати тангенсу або ж котангенсу нашого кута зв’язку. Грубу оцінку ефективного перерізу розсіяння можна оцінити наступним чином. Коефіцієнт поглинання світла  можна податити в наступному вигляді [4] можна податити в наступному вигляді [4]  , (1) , (1)
де  – концентрація відповідних центрів розсіяння та переріз розсіяння (поглинання) кванта світла відповідно; – концентрація відповідних центрів розсіяння та переріз розсіяння (поглинання) кванта світла відповідно;  – число різних за своєю природою центрів розсіяння; – число різних за своєю природою центрів розсіяння;  – знак суми. – знак суми. Для монохроматичного випромінювання знаком суми в (1) можна знехтувати, у цьому випадку, звичайно, ми маємо один механізм поглинання (розсіяння). Для власного поглинання світла число центрів розсіяння  рівне атомній густині решітки. Для InSb рівне атомній густині решітки. Для InSb  ~ 4×1021cм-3; для рубінового лазера ~ 4×1021cм-3; для рубінового лазера  =2×105 cм-1. У цьому випадку переріз ефективного розсіяння (поглинання) одного кванта світла дорівнює =2×105 cм-1. У цьому випадку переріз ефективного розсіяння (поглинання) одного кванта світла дорівнює  5×10-17cм-2. Для якісної оцінки ефекту анізотропії поглинання лазерного випромінювання скористаємося схемою решітки, наведеної на мал.4. Зв’язок 1 – чисто ковалентний, тому що для InSb та InAs його довжина дорівнює сумі ковалентних радіусів відповідних іонів. Для InSb довжина зв’язку 1 дорівнює 2,8×10-8 cм. Кут між напрямком {110} та зв’язком 1 дорівнює 37,5°. Значення “довжини розсіяння” при таких допущеннях рівне 7×10-9 cм. Ефективна довжина ковалентного зв’язку 1 для кристалографічних напрямків {110} та {111} дорівнює 1,56×10-8 cм та 2,33×10-8 cм відповідно. Для сферичної, еліптичної та гантельної конфігурацій ефективний переріз розсіяння змінюється в межах (4 – 6)×10-17 cм-2. Менше значення перерізу розсіяння ніж квадрат “ефективної довжини” пояснюється великими розмірами іонів In та Sb [5]. Ця оцінка коефіцієнта анізотропності поглинання (розсіяння) випромінювання з урахуванням ефективної поверхневої густини ковалентних зв’язків є наступною 5×10-17cм-2. Для якісної оцінки ефекту анізотропії поглинання лазерного випромінювання скористаємося схемою решітки, наведеної на мал.4. Зв’язок 1 – чисто ковалентний, тому що для InSb та InAs його довжина дорівнює сумі ковалентних радіусів відповідних іонів. Для InSb довжина зв’язку 1 дорівнює 2,8×10-8 cм. Кут між напрямком {110} та зв’язком 1 дорівнює 37,5°. Значення “довжини розсіяння” при таких допущеннях рівне 7×10-9 cм. Ефективна довжина ковалентного зв’язку 1 для кристалографічних напрямків {110} та {111} дорівнює 1,56×10-8 cм та 2,33×10-8 cм відповідно. Для сферичної, еліптичної та гантельної конфігурацій ефективний переріз розсіяння змінюється в межах (4 – 6)×10-17 cм-2. Менше значення перерізу розсіяння ніж квадрат “ефективної довжини” пояснюється великими розмірами іонів In та Sb [5]. Ця оцінка коефіцієнта анізотропності поглинання (розсіяння) випромінювання з урахуванням ефективної поверхневої густини ковалентних зв’язків є наступною  . Приблизно ж таке співвідношення між концентраціями донорних центрів антимоніду індію отриманих за допомогою опромінення імпульсами рубінового лазера для відповідних кристалографічних напрямків (рис. 4). Саме короткий час взаємодії оптичного випромінювання з антимонідом індію й дозволяє зв’язати спостережувані ефекти з механізмами власного поглинання оптичного випромінювання (у цьому випадку з розсіянням світла на зв’язку 1 рис. 4). . Приблизно ж таке співвідношення між концентраціями донорних центрів антимоніду індію отриманих за допомогою опромінення імпульсами рубінового лазера для відповідних кристалографічних напрямків (рис. 4). Саме короткий час взаємодії оптичного випромінювання з антимонідом індію й дозволяє зв’язати спостережувані ефекти з механізмами власного поглинання оптичного випромінювання (у цьому випадку з розсіянням світла на зв’язку 1 рис. 4). Однак тут не цілком зрозумілим є механізм утворення дефектів у цих напівпровідниках. При такому співвідношенні між енергією кванта та шириною забороненої зони кожен квант може “порвати” 3-4 зв’язки антимоніду індію та 2-3 зв’язки арсеніду індію. Це також відповідає температурній залежності холлівської рухливості носіїв у опроміненій області. Однак, все таки, як дати відповідь на запитання: чому ж виникають дефекти? На це питання можна відповісти наступним чином. За час взаємодії оптичного випромінювання відбувається “опустошення” зв’язків 1 (рис. 4). Іони індію та сурми в області цього зв’язку знаходяться на мінімальній відстані один від одного. Цілком ймовірно, що “спустошення” відповідних зв’язків призводить до зміщення якраз іонів, які відповідають за ці зв’язки. Вони зміщуються в область “меншої” густини. Так виникають дефекти. Навіть якщо пов’язати час “спустошення” зв’язків із часом життя нерівноважних носіїв (10-7 с.), то за цей час іони з енергією порядку ширини забороненої зони можуть зміститися на відстань, достатню для утворення дефекту. Чим більша інтенсивність збудження, тим більше нерівноважних дефектів утворюється і тим триваліший час вони живуть. Такими дефектами при низьких інтенсивностях опромінення можуть бути віртуальні пари Френкеля, віртуальні дислокації (лінійні дефекти, розмірами більше як по 3-4 атоми у відповідному кристалографічному напрямку). Енергія активації та відпалу таких дефектів співрозмірна з енергією їхнього утворення, тобто порядку співрозмірна з енергією їхнього утворення, тобто порядку  . Процес первинного дефектоутворення в кристалах . Процес первинного дефектоутворення в кристалах  та та  пов’язаний із різною рухливістю атомів індію, сурми та миш’яку, атоми індію в решітці більш рухливі, а в міжвузлях менш рухливі, ніж атоми сурми. Так, коефіцієнт самодифузії атомів індію в антимоніді індію при кімнатній температурі на три порядки більший, ніж сурми [6]: пов’язаний із різною рухливістю атомів індію, сурми та миш’яку, атоми індію в решітці більш рухливі, а в міжвузлях менш рухливі, ніж атоми сурми. Так, коефіцієнт самодифузії атомів індію в антимоніді індію при кімнатній температурі на три порядки більший, ніж сурми [6]:
| 


 Ці ефекти пояснюються тим, що при взаємодії лазерного випромінювання з hn³Eg відбувається інтенсивне дефектоутворення. Причому концентрація дефектів та час їх життя суттєво залежать від інтенсивності їхнього введення, тобто від інтенсивності опромінення. В класичній фізиці напівпровідників вважається, що при взаємодії оптичного випромінювання, частота якого лежить у смузі власного поглинання монокристала, з напівпровідником відбувається адіабатичний процес повернення кристала в початковий стан. Однак, як видно з вищенаведеного, це не так. Наведемо спрощену модель процесу взаємодії лазерного випромінювання з антимонідом індію. Цей кристал може перебувати в наступних фазах (кристалографічних модифікаціях): сфалериту (кубічна), вюрциту (гексагональна), полікристалічній та аморфній. Кожній з цих модифікацій відповідає своя структура та симетрія енергетичних зон кристала. Перехід між ними супроводжується зміною внутрішньої (потенціальної) енергії кристала. Слід зазначити, що фізика взаємодії оптичного випромінювання у смузі власного поглинання з точки зору релаксаційної оптики як слід не розроблена.
Ці ефекти пояснюються тим, що при взаємодії лазерного випромінювання з hn³Eg відбувається інтенсивне дефектоутворення. Причому концентрація дефектів та час їх життя суттєво залежать від інтенсивності їхнього введення, тобто від інтенсивності опромінення. В класичній фізиці напівпровідників вважається, що при взаємодії оптичного випромінювання, частота якого лежить у смузі власного поглинання монокристала, з напівпровідником відбувається адіабатичний процес повернення кристала в початковий стан. Однак, як видно з вищенаведеного, це не так. Наведемо спрощену модель процесу взаємодії лазерного випромінювання з антимонідом індію. Цей кристал може перебувати в наступних фазах (кристалографічних модифікаціях): сфалериту (кубічна), вюрциту (гексагональна), полікристалічній та аморфній. Кожній з цих модифікацій відповідає своя структура та симетрія енергетичних зон кристала. Перехід між ними супроводжується зміною внутрішньої (потенціальної) енергії кристала. Слід зазначити, що фізика взаємодії оптичного випромінювання у смузі власного поглинання з точки зору релаксаційної оптики як слід не розроблена. 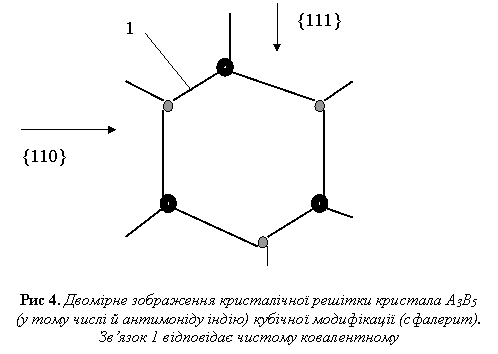
 , (1)
, (1) . Приблизно ж таке співвідношення між концентраціями донорних центрів антимоніду індію отриманих за допомогою опромінення імпульсами рубінового лазера для відповідних кристалографічних напрямків (рис. 4). Саме короткий час взаємодії оптичного випромінювання з антимонідом індію й дозволяє зв’язати спостережувані ефекти з механізмами власного поглинання оптичного випромінювання (у цьому випадку з розсіянням світла на зв’язку 1 рис. 4).
. Приблизно ж таке співвідношення між концентраціями донорних центрів антимоніду індію отриманих за допомогою опромінення імпульсами рубінового лазера для відповідних кристалографічних напрямків (рис. 4). Саме короткий час взаємодії оптичного випромінювання з антимонідом індію й дозволяє зв’язати спостережувані ефекти з механізмами власного поглинання оптичного випромінювання (у цьому випадку з розсіянням світла на зв’язку 1 рис. 4).